1B3-X射线光刻实验站
一、简介
X 射线光刻技术利用 X 射线具有更短的波长和更强的穿透能力的优势,可以实现比传统紫外光刻技术更高的线条精度、更高且更陡直的微结构侧壁,从而获得具有更大高宽比的微结构。使用能量较低(小于 2keV)的 X 光作为光源,可以在较薄光刻胶体系中实现小于 50 纳米的高精度微结构;而使用能量较高(大于 4keV)的 X 光则可以对厚胶(大于 1 毫米)进行曝光,获得极大高宽比的微结构。 实验站配合洁净实验室,主要用于 X 射线光学元件的制备,尤其对含有大高宽比微结构的元件具有制备优势, 如 X 射线折射透镜、波带片、光栅等。所实现的微结构尺寸、厚度覆盖范围广,其器件在 X 射线聚焦、成像领域有着广泛的应用。
二、光源性能及参数
北京同步辐射装置 X 射线光刻站(1B3A)由 1B3 弯铁引出,可通过调节反射镜系统, 实现反射光和直通光两条光路,分别进行适合亚微米线条宽度的纳米光刻和适合大于 1 毫米厚度的 X射线深度光刻。 反射镜可以在竖直方向上移动来切换光路。 当反射镜移开光路时,同步光进入 X 射线深度光刻曝光腔; 当反射镜切入光路时,同步光经由反射镜反射后进入纳米光刻曝光腔,所以两种曝光模式必须分时使用。同步辐射光束在水平方向是均匀分布,在竖直方向为高斯分布, 因此样品台在竖直方向上进行扫描以满足光刻所需要的大面积均匀光斑。图1为1B3A光刻束线的结构示意图。

图1 光束线结构示意图
X射线深度光刻
1B3A 束线由弯铁引出, 光源经过 250 微米厚度的铍窗照射在样品上, 光斑尺寸水平大约 55毫米,竖直 10 毫米。 样品环境为 50kpa 氦气氛, 样品台在竖直方向扫描曝光, 行程最大范围±50 毫米,也可实现不扫描定点曝光。
波长范围: 白光,峰值大约 4.3kev。
曝光面积: 最大 50*80 毫米。
光刻深度: 对于 PMMA 光刻胶最大光刻深度 1.5 毫米。
纳米光刻
1B3A 束线光源经过一个镀铬反射镜反射,然后通过一个 0.5 微米厚的氮化硅膜,再通过 18微米厚度的铍膜(可选)后照射在样品上, 光斑尺寸水平大约 50 毫米,竖直 10 毫米。 样品环境为真空, 样品台在竖直方向扫描曝光, 行程最大范围±50 毫米,也可实现不扫描定点曝光。
波长范围: 白光,峰值大约 1.6kev。
曝光面积: 50*80 毫米。
光刻分辨率:最小线宽 50nm。
1B3A 光束线的同步光在上述两种不同的模式下的光谱分布如图 2 所示, 模拟数据所用储存环电子电流为 100mA, 水平接收角为 1mrad,垂直方向不受限制。
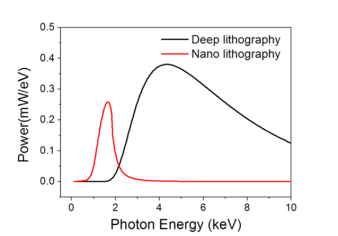
图2 光刻站同步辐射光源在不同模式下的X光能谱分布曲线
三、实验站主要设备
光刻实验站除了具有同步辐射光刻束线的曝光系统外,还拥有较为完善的微加工设备和环境。工作环境有 300 平米的千级洁净间、腐蚀间、工艺辅助间等; 在设备上拥有磁控溅射系统、原子层沉积系统、热蒸发系统、 电镀装置、氧化炉、紫外光刻机、反应离子刻蚀机、 离子束刻蚀机、 ICP 刻蚀系统; 在测试设备方面有台阶仪、显微镜等。图 3 为光刻站千级洁净间照片。

图3 光刻站千级洁净间照片
四、研究工作和应用成果
BSRF 光刻组的研究工作是以同步辐射光刻为核心,通过结合其它微加工手段开展多方位的MEMS 研究和应用,包括 LIGA 技术、 SU8 技术、 硅刻蚀技术等。 目前主要研究方向为 X 射线光学元件的研制, 研究内容包括金属光栅、折射聚焦透镜、波带片、 精密微金属结构系统等。图 4 为利用 1B3A 束线的 LIGA 技术制备出的金光栅照片, 最小线条宽度 2μ m, 厚度可达 90μ m。 图 5 为镍基高能 X 射线复合折射透镜, 适用于对大于 50keV 的 X 光进行聚焦,厚度可以实现大于 1mm。图 6 为 SU8 基 X 射线复合折射透镜, 适用于对小于 80keV 的 X 光进行聚焦,厚度可以实现大于 2mm。
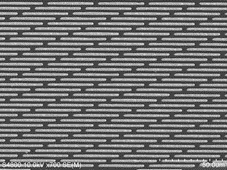
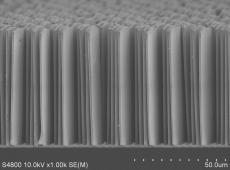
图4 金光栅

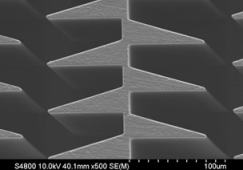
图5 镍基高能X射线复合折射透镜
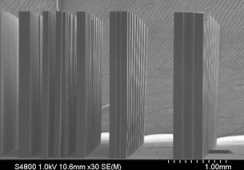
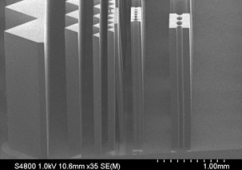
图6 SU8基X射线符合折射透镜
五、联系方式
王 波:010-88235983;wangbo@ihep.ac.cn
